
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Kiváló minőségű SiC kristálynövekedés elérése a hőmérséklet gradiens szabályozásával a kezdeti növekedési fázisban
Bevezetés
A szilícium-karbid (SiC) egy széles sávú félvezető anyag, amely az elmúlt években jelentős figyelmet kapott a nagyfeszültségű és magas hőmérsékletű alkalmazásokban nyújtott kivételes teljesítménye miatt. A fizikai gőzszállítási (PVT) módszerek gyors fejlődése nemcsak a SiC egykristályok minőségét javította, hanem sikeresen elérte a 150 mm-es SiC egykristályok előállítását is. Azonban a minőségeSiC ostyáktovábbra is további javításra szorul, különösen a hibasűrűség csökkentése tekintetében. Jól ismert, hogy a kifejlett SiC kristályokban különféle hibák léteznek, elsősorban a SiC kristálynövekedési folyamat során fellépő hibaképződési mechanizmusok elégtelen megértése miatt. A PVT növekedési folyamatának további mélyreható kutatása szükséges a SiC-kristályok átmérőjének és hosszának növeléséhez, miközben a kristályosodási sebességet is javítani lehet, ezáltal felgyorsítva a SiC-alapú eszközök kereskedelmi forgalomba kerülését. A kiváló minőségű SiC kristálynövekedés elérése érdekében a kezdeti növekedési fázisban a hőmérsékleti gradiens szabályozására összpontosítottunk. Mivel a szilíciumban gazdag gázok (Si, Si2C) károsíthatják a magkristály felületét a kezdeti növekedési fázisban, ezért a kezdeti szakaszban különböző hőmérsékleti gradienseket állítottunk be, és a fő növekedési folyamat során állandó C/Si arányú hőmérsékleti viszonyokhoz igazítottunk. Ez a tanulmány szisztematikusan feltárja a módosított eljárási körülmények között termesztett SiC kristályok különféle jellemzőit.
Kísérleti módszerek
A 6 hüvelykes 4H-SiC golyócskák növekedését PVT módszerrel végeztük 4°-os tengelytől eltérő C-felületen. A kezdeti növekedési fázishoz jobb eljárási feltételeket javasoltak. A növekedési hőmérsékletet 2300-2400 °C közé állítottuk, és a nyomást 5-20 Torr között tartottuk nitrogén- és argongáz környezetben. 6 hüvelykes4H-SiC lapkákszabványos félvezető feldolgozási technikákkal készültek. ASiC ostyákkülönböző hőmérsékleti gradiens körülmények között dolgoztuk fel a kezdeti növekedési fázisban, és 600 °C-on 14 percig marattuk a hibák értékelésére. A felület marási pitsűrűségét (EPD) optikai mikroszkóppal (OM) mértük. A teljes szélesség fele maximumon (FWHM) és a leképezési képek a6 hüvelykes SiC lapkáknagy felbontású röntgendiffrakciós (XRD) rendszerrel mértük.
Eredmények és megbeszélés

1. ábra: A SiC kristálynövekedési mechanizmus vázlata
A kiváló minőségű SiC egykristálynövekedés eléréséhez jellemzően nagy tisztaságú SiC porforrások használatára van szükség, a C/Si arány pontos szabályozására, valamint az állandó növekedési hőmérséklet és nyomás fenntartására. Ezen túlmenően, a kezdeti növekedési fázisban az oltókristályveszteség minimalizálása és a felületi hibák kialakulásának visszaszorítása az oltókristályon. Az 1. ábra a SiC kristálynövekedési mechanizmus vázlatát mutatja be ebben a tanulmányban. Amint az 1. ábrán látható, a gőzgázok (ST) a magkristály felületére kerülnek, ahol diffundálnak és kristályt alkotnak. Néhány, a növekedésben részt nem vevő gáz (ST) deszorbeálódik a kristály felületéről. Ha a magkristály felületén (SG) lévő gáz mennyisége meghaladja a deszorbeált gázt (SD), a növekedési folyamat folytatódik. Ezért a növekedési folyamat során a megfelelő gáz (SG)/gáz (SD) arányt az RF fűtőspirál helyzetének megváltoztatásával vizsgáltuk.
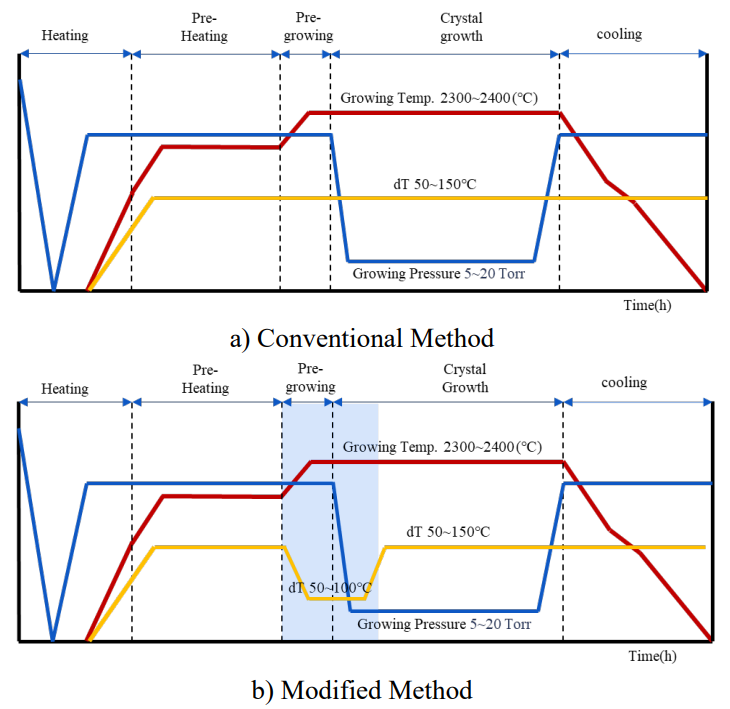
2. ábra: A SiC kristálynövekedési folyamat körülményeinek vázlata
A 2. ábra a SiC kristálynövekedési folyamat körülményeinek vázlatát mutatja ebben a tanulmányban. A tipikus növekedési folyamat hőmérséklete 2300 és 2400 °C között van, a nyomást 5 és 20 Torr között tartják. A növekedési folyamat során a hőmérsékleti gradienst dT=50-150 °C értéken tartjuk (a) hagyományos módszer. Néha a forrásgázok (Si2C, SiC2, Si) egyenetlen ellátása halmozási hibákat, politípus zárványokat okozhat, és ezáltal rontja a kristály minőségét. Ezért a kezdeti növekedési fázisban az RF tekercs helyzetének megváltoztatásával a dT-t gondosan 50-100 °C-on belül szabályoztuk, majd a fő növekedési folyamat során dT=50-150 °C-ra állítottuk ((b) javított módszer) . A hőmérsékleti gradiens (dT[°C] = Tbottom-Tupper) szabályozásához az alsó hőmérsékletet 2300°C-on rögzítettük, a felső hőmérsékletet pedig 2270°C, 2250°C, 2200°C és 2150°C között állítottuk be. Az 1. táblázat az optikai mikroszkópos (OM) felvételeket mutatja be a különböző hőmérsékleti gradiens körülmények között növesztett SiC boule felületről 10 óra elteltével.
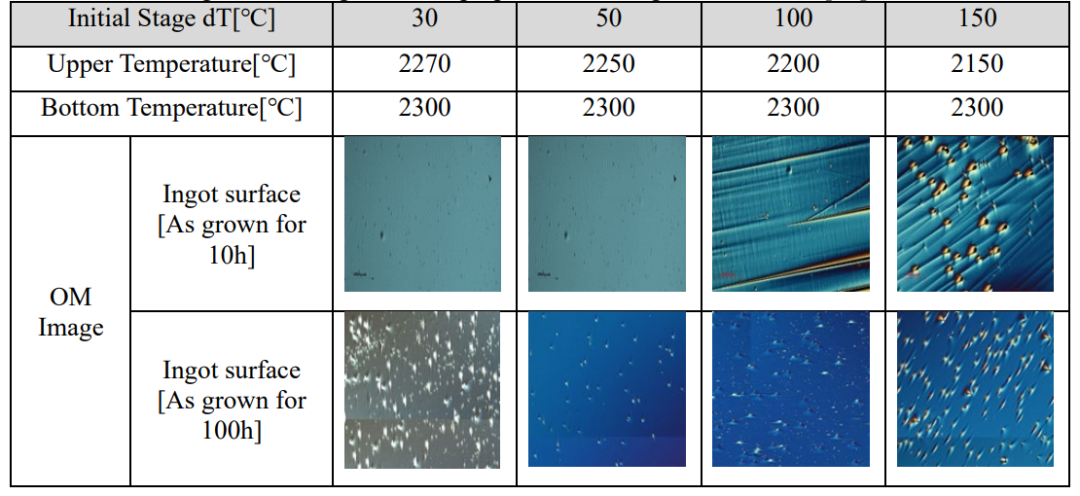
1. táblázat: Optikai mikroszkópos (OM) képek 10 és 100 órán keresztül, különböző hőmérsékleti gradiens körülmények között növesztett SiC Boule felületről
A kezdeti dT=50°C-nál a SiC golyó felszínén a hibasűrűség 10 órás növekedés után szignifikánsan alacsonyabb volt, mint dT=30°C és dT=150°C mellett. dT=30°C-on a kezdeti hőmérsékleti gradiens túl kicsi lehet, ami magkristályveszteséget és hibaképződést eredményez. Ezzel szemben magasabb kezdeti hőmérsékleti gradiensnél (dT=150°C) instabil túltelítettségi állapot léphet fel, ami politípus zárványokhoz és hibákhoz vezethet a magas üresedési koncentráció miatt. Ha azonban a kezdeti hőmérsékleti gradienst optimalizáljuk, akkor a kezdeti hibák kialakulásának minimalizálásával jó minőségű kristálynövekedés érhető el. Mivel a SiC boule felületén a hibasűrűség 100 óra növekedés után hasonló volt a 10 óra utáni eredményekhez, a hibaképződés csökkentése a kezdeti növekedési fázisban a kritikus lépés a kiváló minőségű SiC kristályok előállításában.
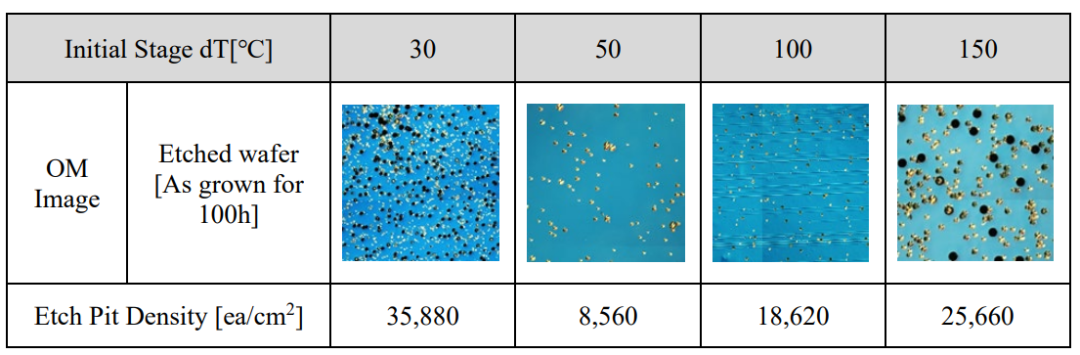
2. táblázat: Maratott SiC golyók EPD értékei különböző hőmérsékleti gradiens körülmények között
OstyaA 100 órán át növesztett golyócskákból készült golyókat marattuk, hogy tanulmányozzuk a SiC kristályok defektussűrűségét, amint az a 2. táblázatban látható. A kezdeti dT=30°C és dT=150°C mellett növesztett SiC kristályok EPD értéke 35 880/cm2 és 25 660 volt. /cm², míg az optimalizált körülmények között növesztett SiC kristályok EPD értéke (dT=50°C) szignifikánsan 8560/cm²-re csökkent.
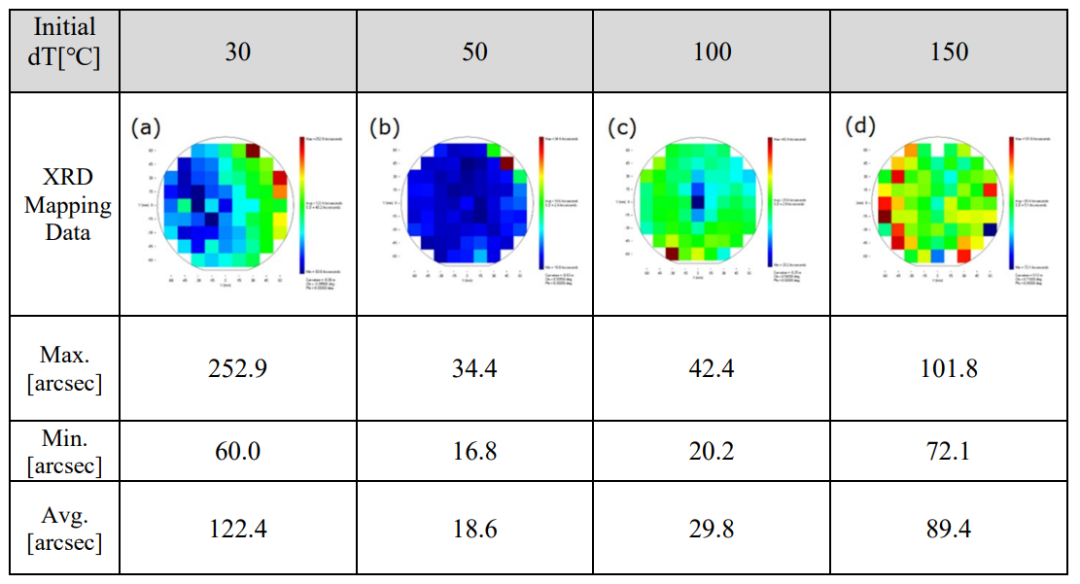
3. táblázat: FWHM értékek és XRD leképezési képek SiC kristályokról különböző kezdeti hőmérsékleti gradiens körülmények között
A 3. táblázat bemutatja a különböző kezdeti hőmérsékleti gradiens körülmények között növesztett SiC kristályok FWHM értékeit és XRD leképezési képeit. Az optimalizált körülmények között (dT=50°C) termesztett SiC kristályok átlagos FWHM értéke 18,6 ívmásodperc volt, szignifikánsan alacsonyabb, mint a más hőmérsékleti gradiens körülmények között termesztett SiC kristályoké.
Következtetés
A kezdeti növekedési fázis hőmérsékleti gradiensének SiC kristályminőségre gyakorolt hatását a hőmérséklet-gradiens (dT[°C] = Tbottom-Tupper) szabályozásával, a tekercs helyzetének változtatásával vizsgáltuk. Az eredmények azt mutatták, hogy a SiC boule felületén a hibasűrűség 10 órás növekedés után kezdeti dT=50°C körülmények között szignifikánsan alacsonyabb volt, mint dT=30°C és dT=150°C mellett. Az optimalizált körülmények között (dT=50°C) termesztett SiC kristályok átlagos FWHM értéke 18,6 ívmásodperc volt, szignifikánsan alacsonyabb, mint a más körülmények között növesztett SiC kristályoké. Ez azt jelzi, hogy a kezdeti hőmérsékleti gradiens optimalizálása hatékonyan csökkenti a kezdeti hibák kialakulását, és ezáltal kiváló minőségű SiC kristálynövekedést ér el.**




