
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiC egykristály szubsztrát feldolgozás
Szilícium-karbid (SiC) egykristályokelsősorban szublimációs módszerrel állítják elő. Miután eltávolítottuk a kristályt a tégelyből, több bonyolult feldolgozási lépésre van szükség a használható ostyák létrehozásához. Az első lépés a SiC boule kristály orientációjának meghatározása. Ezt követően a golyót külső átmérőjű csiszolásnak vetik alá, hogy hengeres formát kapjanak. Az erősáramú eszközökben általánosan használt n-típusú SiC lapkák esetében a hengeres kristály felső és alsó felülete általában úgy van megmunkálva, hogy egy síkot hozzon létre, amely 4°-os szöget zár be az {0001} felülethez képest.
Ezután a feldolgozás az ostya felületének kristály orientációjának meghatározásához irányított él- vagy bevágással folytatódik. A nagy átmérőjű gyártásnálSiC ostyák, az irányított bevágás gyakori technika. A hengeres SiC egykristályt ezután vékony lapokra vágják, elsősorban többhuzalos vágási technikákkal. Ez a folyamat abból áll, hogy csiszolóanyagot helyeznek a vágóhuzal és a SiC kristály közé, miközben nyomást gyakorolnak a vágási mozgás megkönnyítésére.
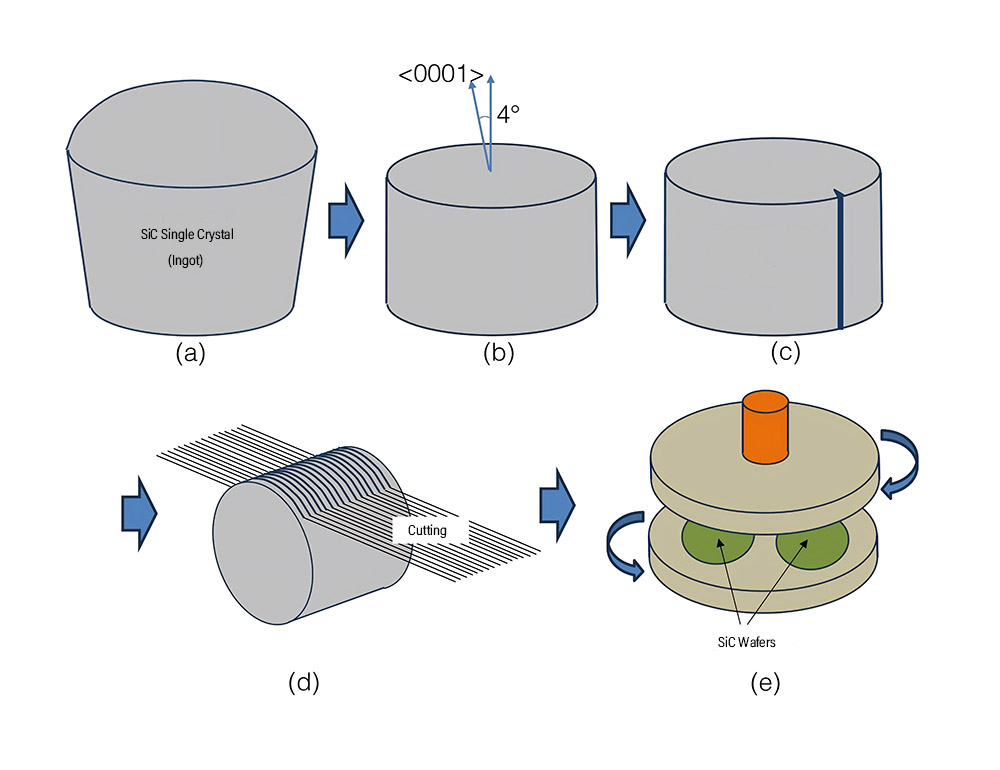
1. ábra A SiC szeletfeldolgozási technológia áttekintése
a) SiC tuskó eltávolítása a tégelyből; b) hengeres köszörülés; c) Irányított él- vagy bevágás; d) többhuzalos vágás; e) Köszörülés és polírozás
Szeletelés után aSiC ostyákgyakran mutatnak vastagságbeli és felületi egyenetlenségeket, ami további simítást tesz szükségessé. Ez csiszolással kezdődik, hogy kiküszöböljük a mikron szintű felületi egyenetlenségeket. Ebben a fázisban a koptató hatás finom karcolásokat és felületi tökéletlenségeket okozhat. Így az ezt követő polírozási lépés kulcsfontosságú a tükörszerű felület eléréséhez. A csiszolással ellentétben a polírozás finomabb csiszolóanyagokat használ, és alapos odafigyelést igényel a karcolások és a belső sérülések elkerülése érdekében, ami nagyfokú felületi simaságot biztosít.
Ezen eljárások révénSiC ostyáka durva megmunkálástól a precíziós megmunkálásig fejlődik, ami végső soron lapos, tükörszerű felületet eredményez, amely alkalmas a nagy teljesítményű eszközökhöz. A polírozott ostyák kerülete körül gyakran kialakuló éles szélek kezelése azonban elengedhetetlen. Ezek az éles szélek más tárgyakkal való érintkezéskor eltörhetnek. Ennek a törékenységnek a csökkentése érdekében az ostya kerületének élcsiszolása szükséges. Ipari szabványokat hoztak létre, hogy biztosítsák az ostyák megbízhatóságát és biztonságát a későbbi használat során.
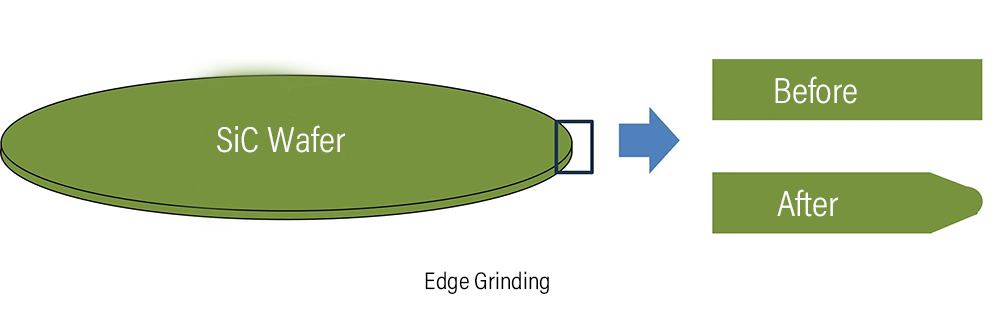
A SiC kivételes keménysége ideális csiszolóanyaggá teszi különféle megmunkálási alkalmazásokban. Ez azonban kihívásokat is jelent a SiC golyócskák ostyává történő feldolgozásában, mivel ez egy időigényes és összetett folyamat, amelyet folyamatosan optimalizálnak. A hagyományos szeletelési módszerek fejlesztésének egyik ígéretes újítása a lézeres vágási technológia. Ennél a technikánál a lézersugarat a hengeres SiC kristály tetejéről irányítják, a kívánt vágási mélységre fókuszálva, hogy egy módosított zónát hozzon létre a kristályon belül. A teljes felület letapogatásával ez a módosított zóna fokozatosan egy síkba tágul, lehetővé téve a vékony lapok szétválasztását. A hagyományos többhuzalos vágáshoz képest, amely gyakran jelentős bevágási veszteséggel jár, és felületi egyenetlenségeket okozhat, a lézeres szeletelés jelentősen csökkenti a bevágási veszteséget és a feldolgozási időt, így ígéretes módszer a jövőbeni fejlesztésekhez.
Egy másik innovatív szeletelési technológia az elektromos kisülési vágás alkalmazása, amely kisüléseket hoz létre a fémhuzal és a SiC kristály között. Ez a módszer előnyökkel büszkélkedhet a bevágási veszteség csökkentésében, miközben tovább növeli a feldolgozási hatékonyságot.
Különleges megközelítés aSiC ostyaA gyártás során vékony SiC egykristály filmet ragasztanak egy heterogén hordozóhoz, ezáltalSiC ostyák. Ez a kötési és leválási folyamat a hidrogénionok befecskendezésével kezdődik a SiC egykristályba előre meghatározott mélységig. A SiC kristályt, amelyet most ion-beültetett réteggel látnak el, egy sima hordozóra, például polikristályos SiC-re rétegezik. Nyomás és hő alkalmazásával a SiC egykristályos réteg a hordozó hordozóra kerül, ezzel teljessé válik a leválás. Az átvitt SiC réteg felületsimító kezelésen esik át, és újra felhasználható a kötési folyamatban. Bár a hordozó hordozó költsége alacsonyabb, mint a SiC egykristályoké, a technikai kihívások továbbra is fennállnak. Mindazonáltal a kutatás és fejlesztés ezen a területen továbbra is aktívan halad előre, és célja a teljes gyártási költségek csökkentéseSiC ostyák.
Összefoglalva, a feldolgozásaSiC egykristály szubsztrátoktöbb szakaszból áll, a csiszolástól és a szeleteléstől a polírozásig és az élkezelésig. Az olyan innovációk, mint a lézeres vágás és az elektromos kisüléses megmunkálás, javítják a hatékonyságot és csökkentik az anyagpazarlást, míg a hordozóragasztás új módszerei alternatív utakat kínálnak a költséghatékony lapkagyártáshoz. Mivel az ipar továbbra is a jobb technikák és szabványok felé törekszik, a végső cél továbbra is a kiváló minőségű termékek előállítása.SiC ostyákamelyek megfelelnek a fejlett elektronikus eszközök követelményeinek.




