
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
ALD bolygószuszceptor
A Semicorex ALD Planetary Susceptor fontos az ALD berendezésekben, mivel képesek ellenállni a zord feldolgozási körülményeknek, és kiváló minőségű filmlerakást biztosítanak különféle alkalmazásokhoz. Ahogy a kisebb méretű és nagyobb teljesítményű fejlett félvezető eszközök iránti kereslet folyamatosan növekszik, az ALD Planetary Susceptor alkalmazása az ALD-ben várhatóan tovább fog bővülni.**
Kérdés küldése
Alkalmazások:
Nagy k dielektromos leválasztás: Az ALD Planetary Susceptor kiválóan ellenáll az agresszív prekurzoroknak, amelyeket a magas k dielektromos anyagok, például a hafnium-oxid (HfO2) és az alumínium-oxid (Al2O3) lerakásához használnak. Ezáltal az ALD Planetary Susceptor alkalmas nagy teljesítményű tranzisztorok gyártására logikai és memóriaalkalmazásokhoz.
Fémezési rétegek: Az ALD Planetary Susceptor magas hőmérsékleti stabilitása lehetővé teszi a fémrétegek magasabb hőmérsékleten történő lerakódását, ami javítja a film tulajdonságait, például alacsonyabb ellenállást és nagyobb sűrűséget. Ez kulcsfontosságú a fejlett félvezető eszközök hatékony összekapcsolásának létrehozásához.
Optoelektronikai eszközök gyártása:Az ALD Planetary Susceptor inert természete minimalizálja a nem kívánt reakciókat az érzékeny anyagok, például a III-V félvezetők lerakására használt prekurzorokkal, így az ALD Planetary Susceptor tökéletesen illeszkedik LED-ek, lézerek és egyéb optoelektronikai alkatrészek gyártásához.
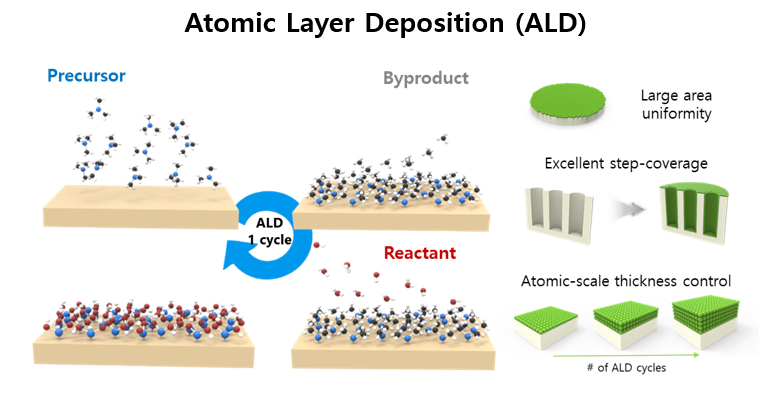
ALD ciklus
Atomic Layer Deposition (ALD)számos kulcsfontosságú előnyt kínál más vékonyréteg-leválasztási technikákkal szemben, így egyre népszerűbb a különféle alkalmazásokban, különösen a mikroelektronikában és a nanotechnológiában.
Íme néhány az ALD legfontosabb előnyei:
1. Angstrom-szintű vastagságszabályozás:
Az ALD lehetővé teszi a filmvastagság pontos szabályozását egészen az angström szintig (0,1 nanométer). Ezt a pontossági szintet önkorlátozó felületi reakcióival érik el, ahol minden ciklus egyetlen atomi réteget rak le.
2. Kiváló egységesség és konformitás:
Az ALD kivételes egységességet mutat nagy felületeken és összetett 3D-s struktúrákon, beleértve a nagy képarányú jellemzőket, mint például árkok és átmenetek. Ez döntő fontosságú olyan alkalmazásoknál, amelyek bonyolult geometriákon egységes bevonatot igényelnek, például félvezető eszközöknél.
3. Alacsony lerakódási hőmérséklet:
Az ALD más leválasztási technikákkal összehasonlítva viszonylag alacsony hőmérsékleten (gyakran 300 °C alatt) is elvégezhető. Ez előnyös a hőérzékeny aljzatoknál, és szélesebb körű anyagok alkalmazását teszi lehetővé.
4. Kiváló minőségű filmek:
Az ALD jellemzően kiváló sűrűségű, alacsony szennyeződési szinttel és nagy egyenletes összetételű és vastagságú filmeket állít elő. Ezek a jellemzők elengedhetetlenek az optimális teljesítmény eléréséhez különböző alkalmazásokban.
5. Széles anyagválaszték:
Az ALD a leválasztható anyagok széles választékát kínálja, beleértve az oxidokat, nitrideket, fémeket és szulfidokat. Ez a sokoldalúság sokféle alkalmazásra alkalmassá teszi.
6. Skálázhatóság és ipari alkalmazhatóság:
Az ALD technológia nagymértékben skálázható, és könnyen integrálható a meglévő gyártási folyamatokba. Különféle méretű és formájú aljzatokkal kompatibilis, így alkalmas nagy volumenű gyártásra.
![]()

![]()
![]()














