
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
A félvezető eszközök teljes gyártási folyamatának megértése
1. Fotolitográfia
A fotolitográfia, amely gyakran egyet jelent a mintázat generálásával, az egyik legkritikusabb hajtóerő a félvezető technológia gyors fejlődése mögött, amely a nyomtatás fényképészeti lemezkészítési folyamataiból származik. Ez a technika lehetővé teszi bármilyen minta bemutatását mikro- vagy nanoléptékben. fotoreziszt, és más folyamattechnológiákkal kombinálva ezeket a mintákat anyagokra viszi át, megvalósítva a félvezető anyagok és eszközök különböző terveit és koncepcióit. A fotolitográfiában használt fényforrás közvetlenül befolyásolja a minták pontosságát, az ultraibolya, mély ultraibolya sugárzástól a röntgen- és elektronsugarakig terjedő lehetőségek közül választhat, amelyek mindegyike megfelel a mintahűség növekvő szintjének az említett sorrendben.
A szabványos fotolitográfiai folyamat magában foglalja a felület előkészítését, adhéziót, lágy sütést, expozíciót, expozíció utáni sütést, előhívást, kemény sütést és ellenőrzést.
A felületkezelés elengedhetetlen, mivel a szubsztrátok jellemzően felszívják a H2O molekulákat a levegőből, ami káros a fotolitográfiára. Ezért a szubsztrátumok kezdetben sütés útján kiszáradáson mennek keresztül.
Hidrofil szubsztrátumok esetén a hidrofób fotoreziszthez való adhéziójuk nem kielégítő, ami potenciálisan a fotoreziszt leválását vagy a minta eltolódását okozhatja, így szükség van tapadást elősegítő anyagra. Jelenleg a hexametil-diszilazán (HMDS) és a tri-metil-szilil-dietil-amin (TMSDEA) széles körben használt tapadásfokozók.
A felületkezelést követően megkezdődik a fotoreziszt felhordása. Az alkalmazott fotoreziszt vastagsága nemcsak a viszkozitásától függ, hanem a centrifugálási sebességtől is, általában fordítottan arányos a centrifugálási sebesség négyzetgyökével. A bevonást követően lágy sütést hajtanak végre, hogy az oldószert elpárologtatják a fotorezisztről, javítva a tapadást az elősütésnek nevezett eljárásban.
Ha ezek a lépések befejeződnek, megtörténik az expozíció. A fotoreziszteket pozitív vagy negatív kategóriába sorolják, az expozíció után ellentétes tulajdonságokkal.
Vegyük például a pozitív fotorezisztet, ahol a meg nem exponált fotoreziszt nem oldódik az előhívóban, de az expozíció után oldódik. Az expozíció során a fényforrás egy mintás maszkon áthaladva megvilágítja a bevont hordozót, mintázva a fotorezisztet. Az expozíciós pozíció pontos szabályozása érdekében a szubsztrátumot általában a maszkhoz kell igazítani az expozíció előtt. Az expozíció időtartamát szigorúan be kell tartani a minta torzulásának elkerülése érdekében. Az expozíció után további sütésre lehet szükség az állóhullámok hatásainak mérséklése érdekében, bár ez a lépés nem kötelező, és megkerülhető a közvetlen fejlesztés érdekében. Az előhívás feloldja a megvilágított fotorezisztet, és a maszk mintázatát pontosan átviszi a fotoreziszt rétegre. A fejlesztési idő szintén kritikus – a túl rövid hiányos fejlesztéshez, a túl hosszú minta torzulásához vezet.
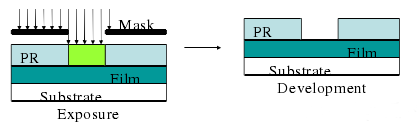
Ezt követően a kemény sütés megerősíti a fotoreziszt film tapadását az aljzathoz, és javítja a marásállóságát. A kemény sütési hőmérséklet általában valamivel magasabb, mint az elősütésé.
Végül a mikroszkópos vizsgálat ellenőrzi, hogy a minta megfelel-e az elvárásoknak. Miután a mintát más eljárással az anyagra vitték, a fotoreziszt betöltötte a célját, ezért el kell távolítani. A sztrippelési módszerek közé tartozik a nedves (erős szerves oldószerek, például aceton használata) és a száraz (oxigénplazma használata a film maratására).
2. Dopping technikák
A félvezető technológiában nélkülözhetetlen a doppingolás, amely szükség szerint megváltoztatja a félvezető anyagok elektromos tulajdonságait. Az általános adalékolási módszerek közé tartozik a termikus diffúzió és az ionimplantáció.
(1) Ionbeültetés
Az ionbeültetés nagy energiájú ionokkal bombázva dobolja a félvezető hordozót. A termikus diffúzióhoz képest számos előnye van. A tömeganalizátorral kiválasztott ionok magas adalékolási tisztaságot biztosítanak. A beültetés során a szubsztrát szobahőmérsékleten vagy valamivel magasabb hőmérsékleten marad. Számos maszkolófólia használható, mint például a szilícium-dioxid (SiO2), a szilícium-nitrid (Si3N4) és a fotoreziszt, amelyek nagy rugalmasságot biztosítanak az önbeálló maszk technikákkal. Az implantátum dózisait pontosan szabályozzák, és a beültetett szennyező ionok eloszlása azonos síkon belül egyenletes, ami nagy ismételhetőséget eredményez.
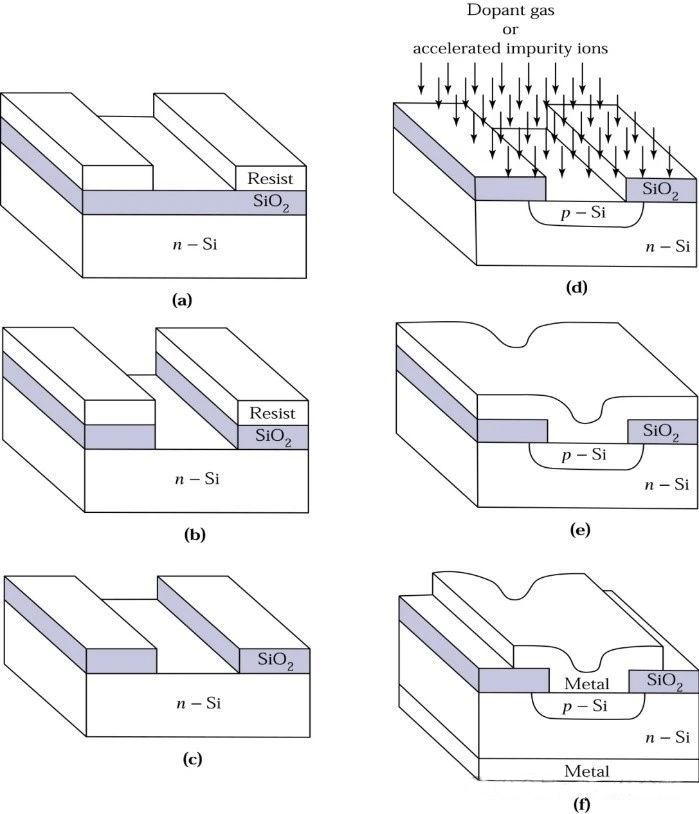
A beültetés mélységét az ionok energiája határozza meg. Az energia és a dózis szabályozásával a szennyező ionok eloszlása a szubsztrátban a beültetés után manipulálható. Különböző sémákkal több beültetés végezhető folyamatosan különböző szennyeződési profilok elérése érdekében. Nevezetesen, az egykristályos szubsztrátumokban, ha a beültetés iránya párhuzamos a krisztallográfiai iránnyal, csatornázási hatások lépnek fel – egyes ionok a csatornákon haladnak, ami kihívást jelent a mélységszabályozás számára.
A csatornázás megakadályozása érdekében a beültetést általában az egykristály hordozó főtengelyéhez képest körülbelül 7°-os szögben hajtják végre, vagy a hordozót amorf réteggel borítják.
Az ionbeültetés azonban jelentősen károsíthatja a hordozó kristályszerkezetét. A nagy energiájú ionok ütközéskor energiát adnak át a szubsztrát atommagjainak és elektronjainak, így azok elhagyják a rácsot, és intersticiális-üresedés-hiba párokat alkotnak. Súlyos esetekben a kristályszerkezet egyes régiókban megsemmisülhet, amorf zónákat képezve.
A rácssérülés nagymértékben befolyásolja a félvezető anyag elektromos tulajdonságait, például csökkenti a hordozó mobilitását vagy a nem egyensúlyi hordozók élettartamát. A legfontosabb, hogy a beültetett szennyeződések többsége szabálytalan intersticiális helyeket foglal el, és nem képez hatékony doppingot. Ezért elengedhetetlen a beültetés utáni rácskárosodás javítása és a szennyeződések elektromos aktiválása.
(2)Rapid Thermal Processing (RTP)
A hőkezelés a leghatékonyabb módszer az ionbeültetés és az elektromosan aktiválódó szennyeződések okozta rácskárosodások javítására. Magas hőmérsékleten a hordozó kristályrácsában lévő intersticiális-üresedés-hibapárok újraegyesülnek és eltűnnek; az amorf régiók is átkristályosodnak az egykristályos területek határától a szilárd fázisú epitaxia révén. A hordozóanyag magas hőmérsékleten történő oxidációjának elkerülése érdekében a hőkezelést vákuumban vagy inert gázatmoszférában kell végrehajtani. A hagyományos izzítás hosszú időt vesz igénybe, és a diffúzió miatt jelentős szennyeződés-újraeloszlást okozhat.
Az eljöveteleRTP technológiafoglalkozik ezzel a problémával, nagyrészt megvalósítva a rácssérülések javítását és a szennyeződések aktiválását rövidebb hőkezelési időtartamon belül.
A hőforrástól függőenRTPtöbb típusba sorolható: elektronsugaras pásztázás, impulzusos elektron- és ionsugarak, impulzuslézerek, folytonos hullámú lézerek és szélessávú inkoherens fényforrások (halogénlámpák, grafitfűtőtestek, ívlámpák), ez utóbbiak a legszélesebb körben használtak. Ezek a források egy pillanat alatt fel tudják melegíteni a szubsztrátumot a kívánt hőmérsékletre, rövid időn belül befejezve az izzítást és hatékonyan csökkentve a szennyeződések diffúzióját.
3. Filmleválasztási technikák
(1) Plazma-erősített kémiai gőzleválasztás (PECVD)
A PECVD a kémiai gőzfázisú leválasztás (CVD) egyik formája a filmleválasztáshoz, a másik kettő pedig az atmoszférikus nyomású CVD (APCVD) és az alacsony nyomású CVD (LPCVD).
Jelenleg a PECVD a legszélesebb körben alkalmazott három típus közül. Rádiófrekvenciás (RF) plazmát használ, hogy viszonylag alacsony hőmérsékleten kémiai reakciókat indítson el és tartson fenn, ezáltal elősegíti az alacsony hőmérsékletű filmlerakódást nagy lerakódási sebesség mellett. Felszerelésének vázlata a képen látható.
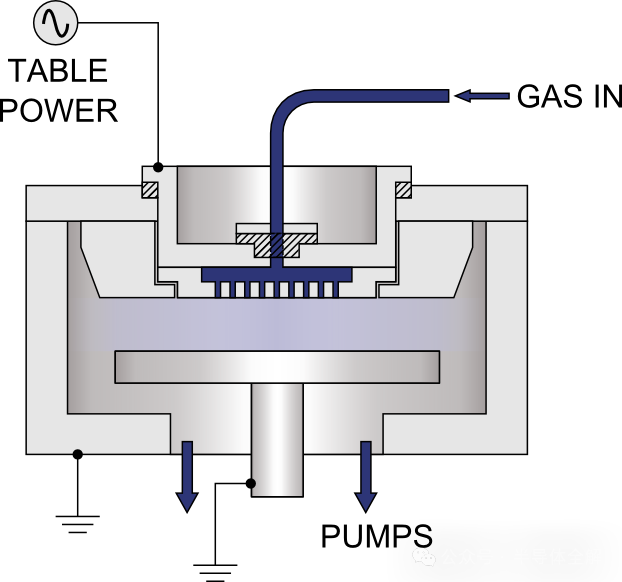
Az ezzel a módszerrel előállított fóliák kivételes adhéziós és elektromos tulajdonságokat, minimális mikroporozitást, nagy egyenletességet és robusztus kis léptékű töltési képességeket mutatnak. A PECVD leválasztás minőségét befolyásoló tényezők közé tartozik a szubsztrátum hőmérséklete, a gáz áramlási sebessége, a nyomás, a rádiófrekvenciás teljesítmény és a frekvencia.
(2) Porlasztás
A porlasztás egy fizikai gőzfázisú leválasztás (PVD) módszer. A töltött ionok (általában Argon ionok, Ar+) elektromos térben felgyorsulnak, így mozgási energiát nyernek. A célanyag felé irányulnak, és a célmolekulákkal ütköznek, és ezek elmozdulását és szétszóródását okozzák. Ezek a molekulák jelentős kinetikus energiával is rendelkeznek, és a szubsztrát felé haladnak, lerakódnak rajta.

A tipikusan alkalmazott porlasztó áramforrások közé tartozik az egyenáramú (DC) és a rádiófrekvenciás (RF), ahol az egyenáramú porlasztás közvetlenül alkalmazható vezető anyagokra, például fémekre, míg a szigetelőanyagok RF-porlasztást igényelnek a filmleválasztáshoz.
A hagyományos porlasztás az alacsony lerakódási sebességtől és a magas üzemi nyomástól szenved, ami alacsonyabb filmminőséget eredményez. A mágnesporlasztás ideálisabban kezeli ezeket a problémákat. Külső mágneses mezőt alkalmaz, hogy az ionok lineáris pályáját a mágneses tér iránya körüli spirális pályára változtassa, meghosszabbítja útjukat és javítja a célmolekulákkal való ütközési hatékonyságot, ezáltal növelve a porlasztási hatékonyságot. Ez növeli a lerakódási sebességet, csökkenti a munkanyomást és jelentősen javítja a film minőségét.
4. Rézkarc Technikák
A maratást száraz és nedves módokra osztják, melyeket konkrét megoldások használatáról (vagy hiányáról) neveznek el.
A maratáshoz általában egy maszkréteg előkészítése szükséges (amely közvetlenül lehet fotoreziszt), hogy megvédje a maratásra nem szánt területeket.
(1) Száraz maratás
A gyakori száraz maratási típusok közé tartozikInduktív csatolású plazma (ICP) maratás, Ion Beam Etching (IBE) és Reactive Ion Etching (RIE).
Az ICP maratás során az izzító kisüléssel előállított plazma számos kémiailag igen aktív szabad gyököt (szabad atomokat, molekulákat vagy atomcsoportokat) tartalmaz, amelyek kémiai reakcióba lépnek a célanyaggal, illékony termékeket képezve ezzel a maratást.
Az IBE nagy energiájú (inert gázokból ionizált) ionokat alkalmaz, hogy közvetlenül bombázza a célanyag felületét maratáshoz, ami egy fizikai folyamatot képvisel.
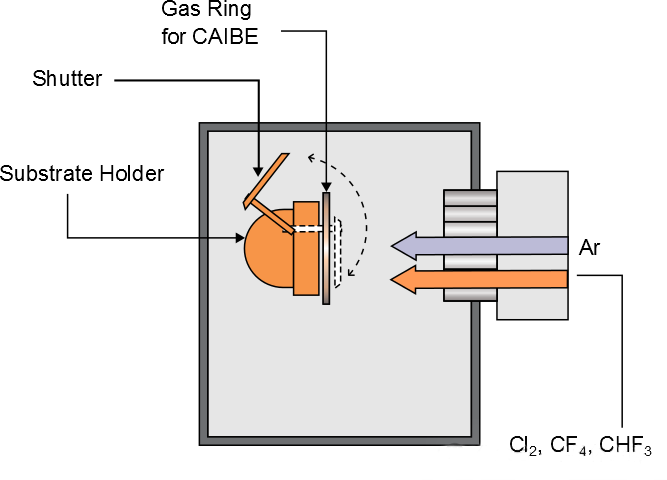
A RIE-t az előző kettő kombinációjának tekintik, amely az IBE-ben használt inert gázt az ICP-maratáshoz használt gázzal helyettesíti, és ezáltal a RIE-t alkotja.
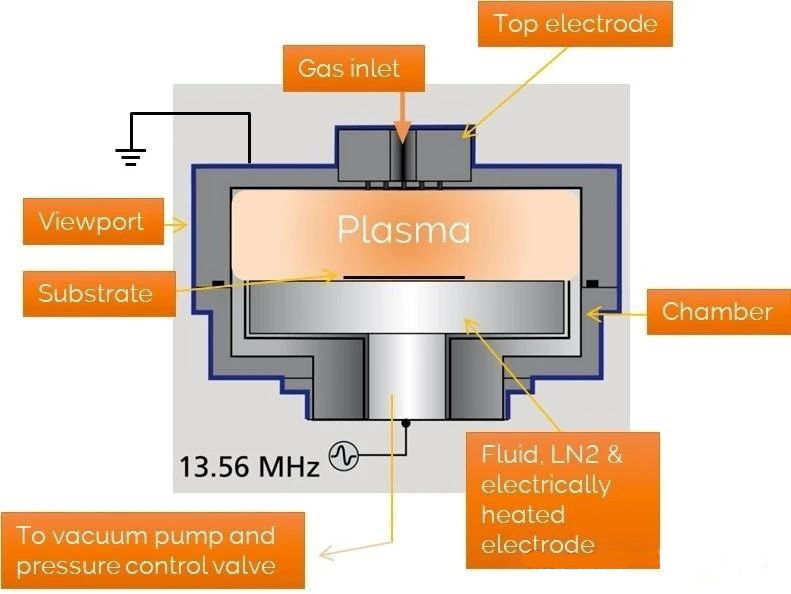
Száraz marásnál a függőleges maratási sebesség jóval meghaladja az oldalsó sebességet, vagyis nagy a képaránya, ami lehetővé teszi a maszkminta pontos replikációját. Azonban a száraz maratással a maszkréteget is maratja, ami gyengébb szelektivitást mutat (a célanyag és a maszkréteg maratási sebességének aránya), különösen IBE esetén, amely nem szelektíven marathatja át az anyag felületét.
(2) Nedves maratás
A nedves maratás azt a maratási módszert jelöli, amelyet úgy érnek el, hogy a célanyagot olyan oldatba (maratószerbe) merítik, amely kémiailag reagál vele.
Ez a maratási módszer egyszerű, költséghatékony, és jó szelektivitást mutat, de alacsony a képaránya. A maszk szélei alatti anyag korrodálódhat, így kevésbé pontos, mint a száraz maratással. Az alacsony oldalarány negatív hatásainak mérséklése érdekében megfelelő maratási sebességet kell választani. A maratási sebességet befolyásoló tényezők közé tartozik a maratószer koncentrációja, a maratási idő és a maratási hőmérséklet.**




