
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe a chipgyártásban: Professzionális hírjelentés
A félvezető anyagok fejlődése
A modern félvezető-technológia területén a miniatürizálás iránti könyörtelen törekvés a hagyományos szilícium alapú anyagok határait feszegette. A nagy teljesítmény és az alacsony energiafogyasztás iránti igények kielégítése érdekében a SiGe (szilícium germánium) egyedülálló fizikai és elektromos tulajdonságai miatt a félvezető chipek gyártásában a választott kompozit anyaggá vált. Ez a cikk aepitaxiás folyamata SiGe és szerepe az epitaxiális növekedésben, a feszült szilícium alkalmazásokban és a Gate-All-Around (GAA) struktúrákban.
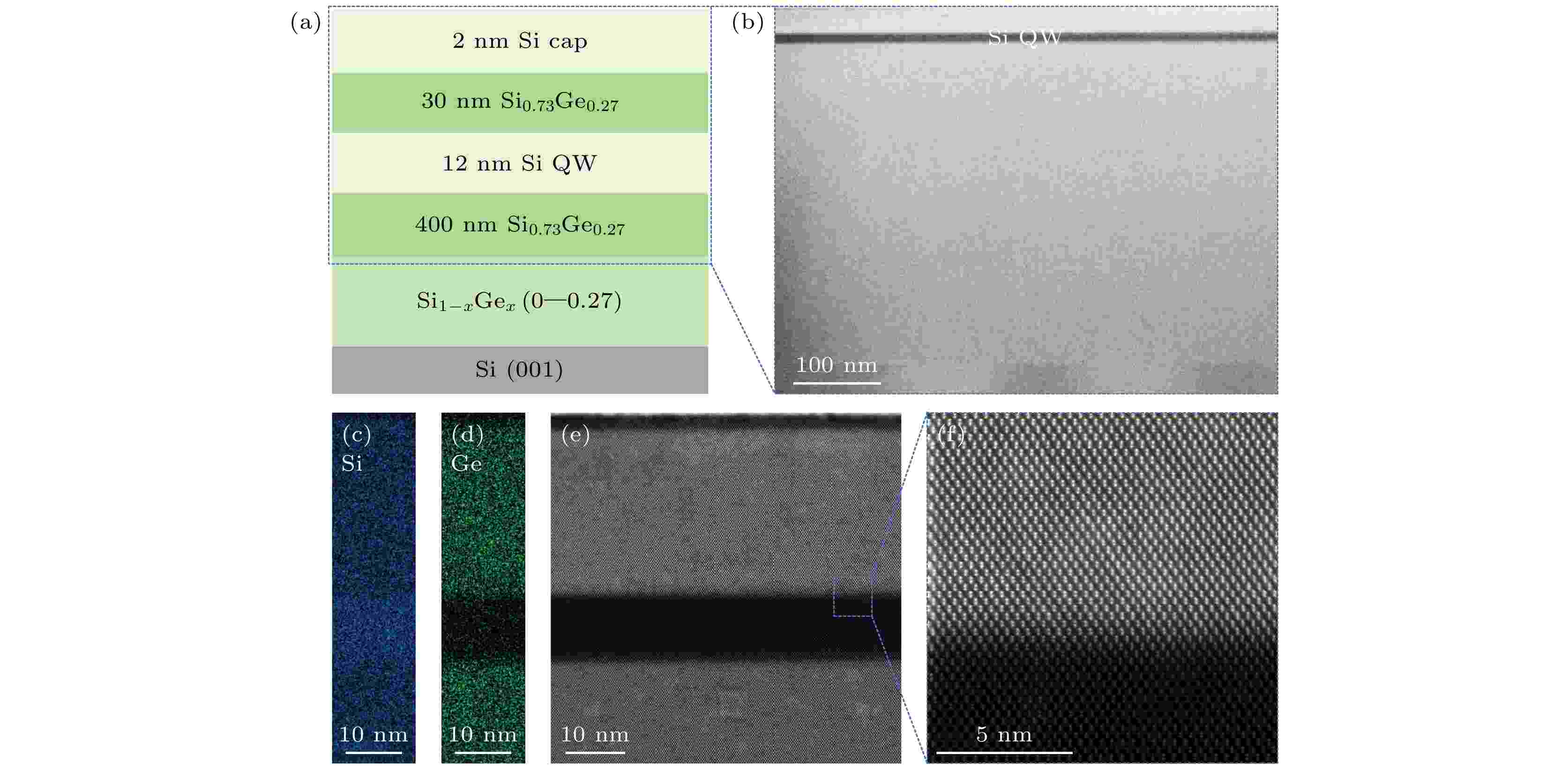
A SiGe Epitaxy jelentősége
1.1 Bevezetés az epitaxiába a chipgyártásban:
Az epitaxia, amelyet gyakran Epi-ként rövidítenek, egy kristályréteg növekedését jelenti egykristályos hordozón, azonos rácselrendezéssel. Ez a réteg lehet bármelyikhomoepitaxiális (például Si/Si)vagy heteroepitaxiális (például SiGe/Si vagy SiC/Si). Különféle módszereket alkalmaznak az epitaxiális növekedéshez, beleértve a molekuláris sugár-epitaxiát (MBE), az ultra-nagy vákuum-kémiai gőzleválasztást (UHV/CVD), az atmoszférikus és csökkentett nyomású epitaxiát (ATM & RP Epi). Ez a cikk a szilícium (Si) és a szilícium-germánium (SiGe) epitaxiás folyamataira összpontosít, amelyeket széles körben használnak a félvezető integrált áramkörök gyártásában, szilícium hordozóanyaggal.
1.2 A SiGe Epitaxy előnyei:
Bizonyos arányú germánium (Ge) beépítése során aepitaxiás folyamatSiGe egykristály réteget képez, amely nemcsak a sávszélességet csökkenti, hanem növeli a tranzisztor határfrekvenciáját (fT). Ez széles körben alkalmazhatóvá teszi a vezeték nélküli és optikai kommunikációt szolgáló nagyfrekvenciás eszközökben. Ezenkívül a fejlett CMOS integrált áramköri folyamatokban a Ge és Si közötti rács eltérés (körülbelül 4%) rácsfeszültséget okoz, növelve az elektronok vagy lyukak mobilitását, és ezáltal növelve az eszköz telítési áramát és válaszsebességét.
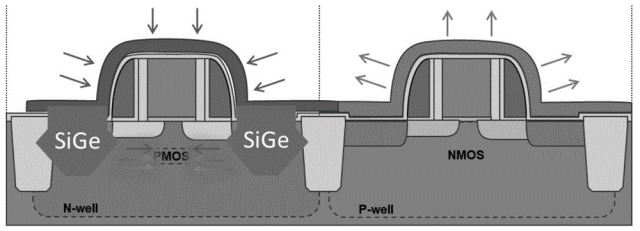
Az átfogó SiGe Epitaxy folyamatfolyamat
2.1 Előkezelés:
A szilícium ostyák előkezelése a kívánt folyamateredmények alapján történik, elsősorban a természetes oxidréteg és az ostya felületén lévő szennyeződések eltávolításával. Erősen adalékolt szubsztrát lapkák esetében döntő fontosságú annak mérlegelése, hogy szükség van-e a hátsó tömítésre az önadalékolás csökkentése érdekében a későbbiekbenepitaxiás növekedés.
2.2 Növekedési gázok és feltételek:
Szilíciumgázok: Szilán (SiH₂), diklórszilán (DCS, SiH₂Cl₂) és triklórszilán (TCS, SiHCl3) a három leggyakrabban használt szilíciumgázforrás. A SiH₄ alkalmas alacsony hőmérsékletű teljes epitaxiás eljárásokra, míg a gyors növekedési üteméről ismert TCS-t széles körben alkalmazzák vastag hám előállítására.szilícium epitaxiarétegek.
Germániumgáz: A germánium hozzáadásának elsődleges forrása a Germane (GeH₄), amelyet szilíciumforrásokkal együtt használnak SiGe ötvözetek előállítására.
Szelektív epitaxia: A szelektív növekedés a relatív arányok beállításával érhető elepitaxiális lerakódásés in situ maratással, klórtartalmú szilíciumgáz DCS használatával. A szelektivitás annak köszönhető, hogy a Cl atomok adszorpciója a szilícium felületén kisebb, mint az oxidokon vagy nitrideken, ami megkönnyíti az epitaxiális növekedést. A Cl atomokat nem tartalmazó és alacsony aktiválási energiájú SiH₄-t általában csak alacsony hőmérsékletű teljes epitaxiás eljárásokban alkalmazzák. Egy másik gyakran használt szilíciumforrás, a TCS, alacsony gőznyomású, és szobahőmérsékleten folyékony, ezért a reakciókamrába H2-buborékolást igényel. Azonban viszonylag olcsó, és gyors növekedési sebessége miatt (akár 5 μm/percig) gyakran használják vastagabb szilícium epitaxiás rétegek növesztésére, széles körben alkalmazzák a szilícium epitaxiás lapkák gyártásában.
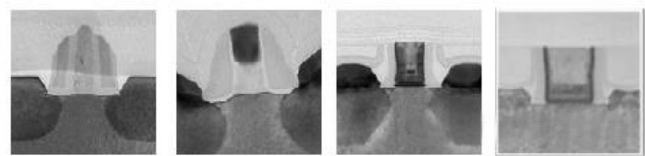
Feszült szilícium epitaxiális rétegekben
Alattepitaxiális növekedés, epitaxiális egykristályos Si egy relaxált SiGe rétegre rakódik le. A Si és SiGe közötti rács eltérés miatt a Si egykristályos réteg húzófeszültségnek van kitéve az alatta lévő SiGe rétegből, ami jelentősen növeli az NMOS tranzisztorok elektronmobilitását. Ez a technológia nem csak növeli a telítési áramot (Idsat), hanem javítja az eszköz válaszidejét is. A PMOS eszközök esetében a SiGe rétegeket epitaxiálisan növesztik a forrás és a lefolyó régiókban a maratást követően, hogy nyomófeszültséget hozzon létre a csatornán, fokozva a lyuk mobilitását és növelve a telítési áramot.
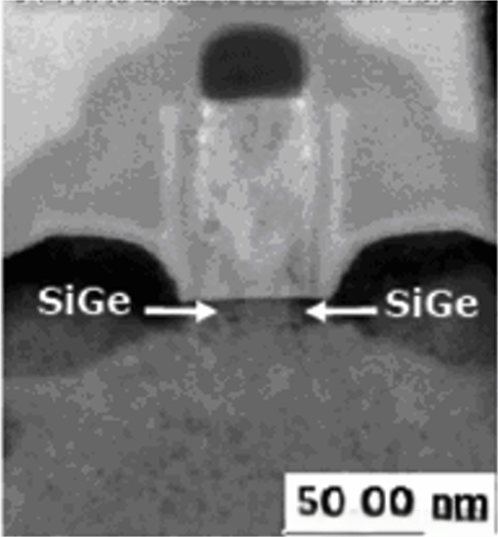
SiGe, mint áldozati réteg a GAA-struktúrákban
A Gate-All-Around (GAA) nanovezetékes tranzisztorok gyártása során a SiGe rétegek áldozati rétegként működnek. A nagy szelektivitású anizotróp maratási technikák, mint például a kvázi-atomi rétegmaratás (kvázi-ALE), lehetővé teszik a SiGe-rétegek precíz eltávolítását nanoszál vagy nanolemez szerkezetek kialakításához.
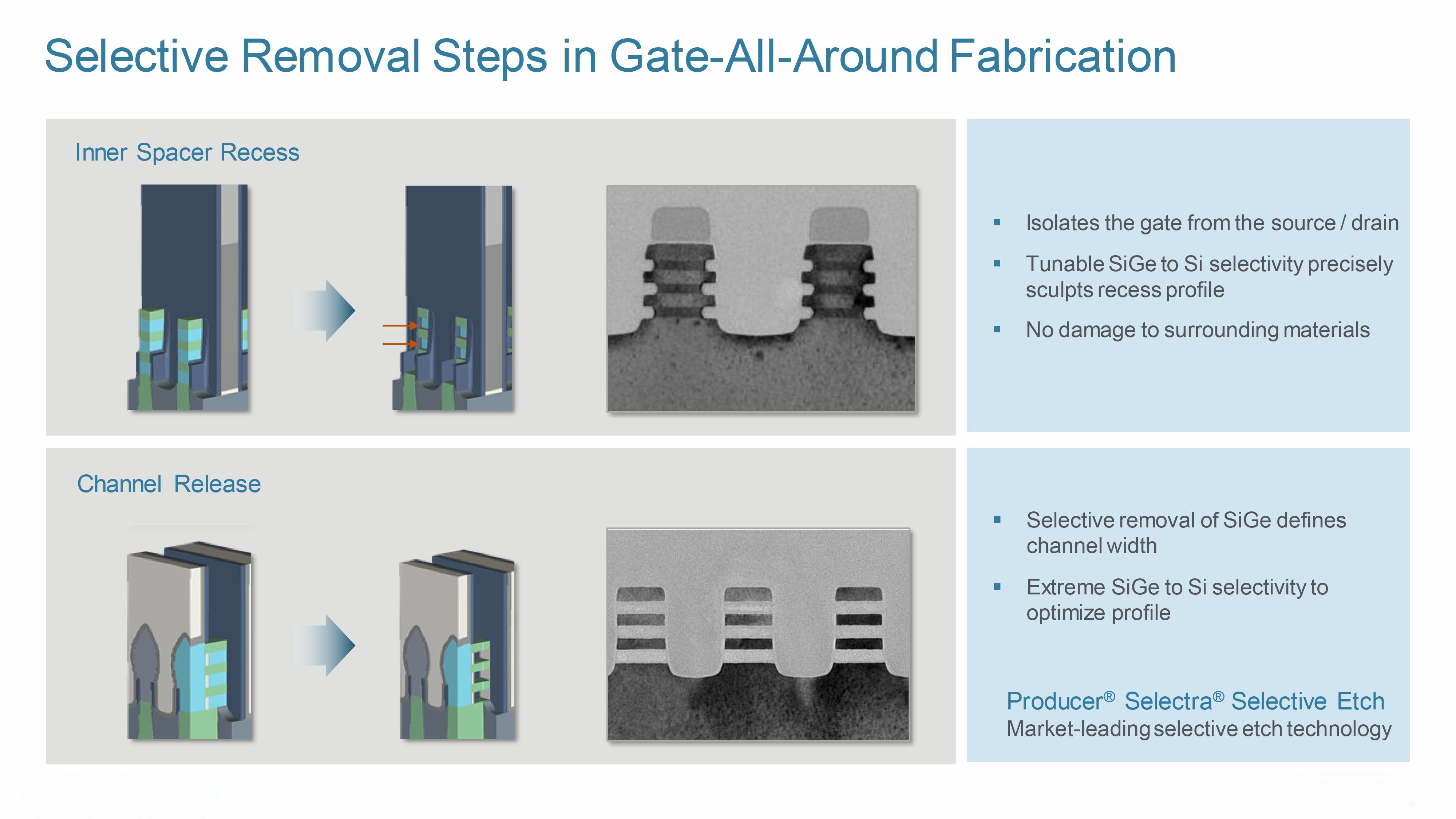
Mi a Semicorexnél arra specializálódtunkSiC/TaC bevonatú grafit oldatokSi epitaxiális növekedésben alkalmazzák a félvezetőgyártásban, ha bármilyen kérdése van, vagy további részletekre van szüksége, kérjük, forduljon hozzánk bizalommal.
Elérhetőség: +86-13567891907
E-mail: sales@semicorex.com




